FlipChip Bonders
ACCµRA100
L’ACCµRA100 est un Flip-Chip Bonder semi-automatique permettant d’atteindre une précision post-assemblage de ± 0.5 µm. Sa flexibilité le rend idéal pour un large éventail d’applications. L’ACCµRA100 combine haute précision, accessibilité et coût attractif. C’est l’équipement parfait pour les universités et les instituts de R&D.
Avantages
- Précision post-assemblage de ± 0.5 µm
- Faible encombrement
- Facile d’utilisation
- Mise au point rapide
- Orienté R&D
- Haute force
Procédés
- Thermocompression
- Refusion
- Polymérisation UV
- Au, Au/Sn, In, Cu, Cu/Sn
- Adhésifs
- Thermosonique

ACCµRA M – FlipChip Bonder manuel
L’ACCµRA M est un Flip-Chip Bonder manuel qui permet d’assembler les composants avec une précision post-assemblage de ± 3 µm.Le bras motorisé contrôle précisément la force de soudage. Combinant et synchronisant ce bras avec le contrôleur de température, l’ACCµRA M garantit une qualité parfaite et une haute répétabilité de votre procédé. Plus qu’un système de prise et placement (« pick and place »), l’ACCµRA M offre des capacités de thermocompression et de refusion. C’est l’équipement idéal pour les universités et les instituts de R&D.
Avantages
- Précision post-assemblage de ± 3 µm
- Faible encombrement
- Facile d’utilisation
- Plateforme ouverte
- Orienté R&D
Procédés
- Thermocompression
- Refusion
- Polymérisation UV
- Au, Au/Sn, In, Cu

SET FC150 – FlipChip Bonder automatique
La FC150 PLATINUM est un Flip-Chip Bonder polyvalent, dédié à la R&D avancée et aux lignes pilotes.
Avantages
- Précision post-assemblage de ± 0.7 µm
- Microscope à fort grossissement pour une image nette des composants
- Facile à utiliser, configuration rapide de nouvelles applications
- Contrôle du parallélisme pour garantir une très grande précision même sous des forces élevées
- Mode manuel (pas à pas) et automatique
- Enregistrement des processus pour le développement, fichiers journaux pour suivre la production
Procédés
- Flip-Chip / Die bonding
- Thermocompression
- Thermosonic
- Reflow
- UV / Thermal curing adhesives, polymers

SET FC300 – FlipChip Bonder automatique
Le Flip-Chip Bonder FC300 est la dernière génération d’équipements haute précision et haute force pour l’assemblage puce-à-puce -jusqu’à 100 mm- et puce-sur-wafer -jusqu’à 300 mm, avec une précision post-assemblage de 0.3 µm. Le FC300 couvre une large gamme de forces d’assemblage, de 1 à 4000 N. Cela le rend parfaitement adapté aux processus de refusion et de thermocompression. Le nivellement entre les deux composants est ajusté avant chaque assemblage à 1 μradian près. Le réglage du parallélisme, l’alignement haute résolution et le contrôle parfait de tous les paramètres permettent d’atteindre une précision post-assemblage submicronique.
Avantages
- Précision post-assemblage de ± 0.3 µm
- Assemblage à faible / haute force
- Parfait contrôle du parallélisme
- Gaz de confinement dont acide formique
- Système de vision unique
- De la R&D à la ligne pilote
Procédés
- Flip-Chip / Die bonding
- Thermocompression
- Reflow
- Adhesive bonding
- Polymérisation UV
- Thermosonique
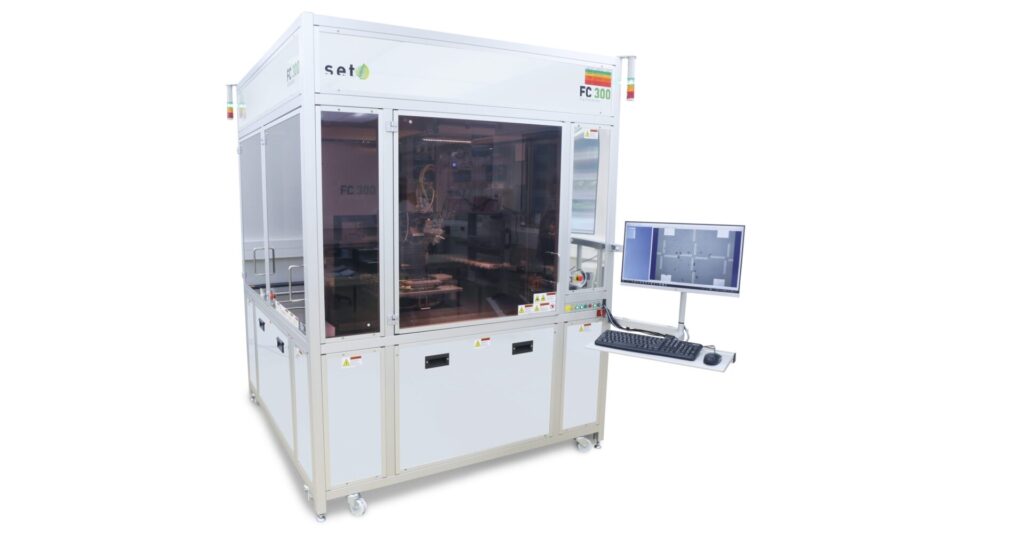
ACCµRA OPTO
L’ACCμRA OPTO est un bonder flip-chip qui permet une précision post-bond de ± 0,5 μm. Il est dédié aux processus de faible force et de refusion. Les axes motorisés garantissent une grande répétabilité de votre processus. L’ACCμRA OPTO allie haute précision, flexibilité et accessibilité. C’est l’équipement parfait pour les applications optoélectroniques et photoniques sur silicium.
Principaux avantages
- Précision post-bond de ± 0,5 μm
- Faible encombrement
- Facile à utiliser
- Mise en place rapide
- Orienté R&D
- Faible force
Capacités du processus
- Thermocompression
- Reflow
- Durcissement par UV
- Au, Au/Sn, In, Cu, Cu/Sn

ACCµRA Plus
L’ACCμRA Plus est un flip-chip-bonder qui permet une précision de ± 0,5 µm @ 3 σ post-bond en mode entièrement automatique. Cet appareil est adapté à la refusion et à la thermocompression. L’ACCμRA Plus associe haute précision, temps de cycle court et flexibilité. Il est spécialisé dans la production pour les applications optoélectroniques et photoniques au silicium.
Principaux avantages
- Précision de ± 0.5 µm @ 3 σ post-bond.
- Haute précision et haut débit
- Entièrement automatique
- Grande flexibilité et fiabilité
- Matrices ultra petites
Capacités du processus
- Flip-chip / Die Bonding
- Thermocompression
- Reflow
- Durcissement UV
- Au, Au/Sn, In, Cu
- Pick & Place
 Produits video (youtube.com)
Produits video (youtube.com)

NEO HB
Le NEO HB est un flip-chip-bonder automatique conçu pour une précision post-bond de ± 0,5 µm @ 3 σ en mode autonome ou entièrement automatique. Il est adapté au bonding hybride / direct. Le NEO HB allie haute précision, flexibilité et temps de cycle court. Il est dédié à la production.
Principaux avantages
- Précision post-bond de ± 0.5 µm @ 3 σ
- Fonctions entièrement automatisées
- Interface utilisateur conviviale
- Haute précision de répétition grâce au système en boucle fermée
- Compatible du mode autonome au mode entièrement automatique
- Degré de pureté ISO 5 en mode autonome / ISO 3 en mode entièrement automatique
Capacités du processus
- Hybrid / direct bonding à température ambiante
- Flip-chip bonding, die bonding
Traduit avec DeepL.com (version gratuite)

NPS300
Le NPS300 est axé sur la recherche et le développement avancés ainsi que sur les lignes pilotes. Il s’agit d’un stepper de haute précision et de grande force, conçu pour la nanogravure. Le NPS300 est optimisé pour la réplication de nanostructures avec une précision de ± 0,5 μm et est le tout premier outil capable de combiner la lithographie par dorure à chaud alignée et le NIL UV sur la même plateforme. Le NPS300 est capable d’imprimer des géométries inférieures à 20 nm avec une précision de superposition de 250 nm. Son architecture flexible offre une excellente reproductibilité du processus et une capacité unique à structurer de grandes surfaces en mode séquentiel Step & Repeat sur des wafers jusqu’à 300 mm. Elle permet de produire à moindre coût de grands tampons avec des motifs répétitifs.
Principaux avantages
- Précision de ± 0,5 μm
- Mode step & repeat sur des wafers jusqu’à 300 mm
- Récupération automatique des timbres
- La technologie des paliers à air et la structure en granit assurent une stabilité et une fiabilité à long terme.
- Contrôle du parallélisme pour garantir une très grande précision même en cas de forces élevées
- Calibrage mains libres/entièrement automatique
- Cycle automatique et indépendant de l’opérateur
- Rendement élevé grâce à une conception rigide
Enregistrement du processus pour le développement
- Fichiers journaux pour le suivi de la production
- Capacités du processus
L’étape & le poinçon de gaufrage lithographie pour le marquage à chaud ou UV-NIL est un procédé innovant qui a été démontré au centre de recherche technique VTT en Finlande.
Lithographie d’estampage à chaud : ce procédé consiste à transférer le modèle de tampon dans un matériau d’estampage thermoplastique par contrôle de la chaleur et de la pression.
UV-NIL : le procédé pas à pas & durcissement utilise un matériau de marquage dosé sur place et un durcissement par UV. Cette technologie innovante est une solution prometteuse pour remplacer les systèmes de lithographie UV standard lorsque la résolution requise est inférieure à 20 nm.

LDP150
La LDP150 est une presse électrique spécialement conçue pour le bonding de grands détecteurs de lumière ou de rayonnement (50 ~ 150 mm). Elle utilise un processus de compression à température ambiante (option de thermocompression disponible). Un espace prédéfini peut être atteint entre deux composants qui ont déjà été connectés auparavant avec un appareil de bonding de haute précision comme le SET FC150 ou le FC300. Le LDP 150 est capable d’appliquer une pression allant jusqu’à 100 000 N. L’appareil est comprimé à température ambiante tout en conservant la grande précision initiale d’alignement et de parallélisme.
Les principaux avantages
- Boule d’auto-nivellement se déplaçant sur le coussin d’air et bloquée par le vide, préservant le parallélisme d’origine de l’empilement des composants.
- La force élevée (jusqu’à 100.000 N) et le profil de force contrôlé garantissent la qualité du bonding.
- Le socle en granit et la structure rigide en acier maintiennent la haute précision initiale de l’assemblage.
Processus de bonding
- Compression à température ambiante
- Thermocompression (en option)
- Le bonding s’effectue en appuyant sur les composants et en contrôlant précisément le profil de force.
- La priorité peut être donnée soit à la force, soit à la variation de l’écart.
- Le parallélisme et l’écart sont surveillés tout au long de la séquence de bonding.
Les appareils sont comprimés à température ambiante tout en conservant la haute précision initiale de l’alignement et du parallélisme.