LAB
LAB
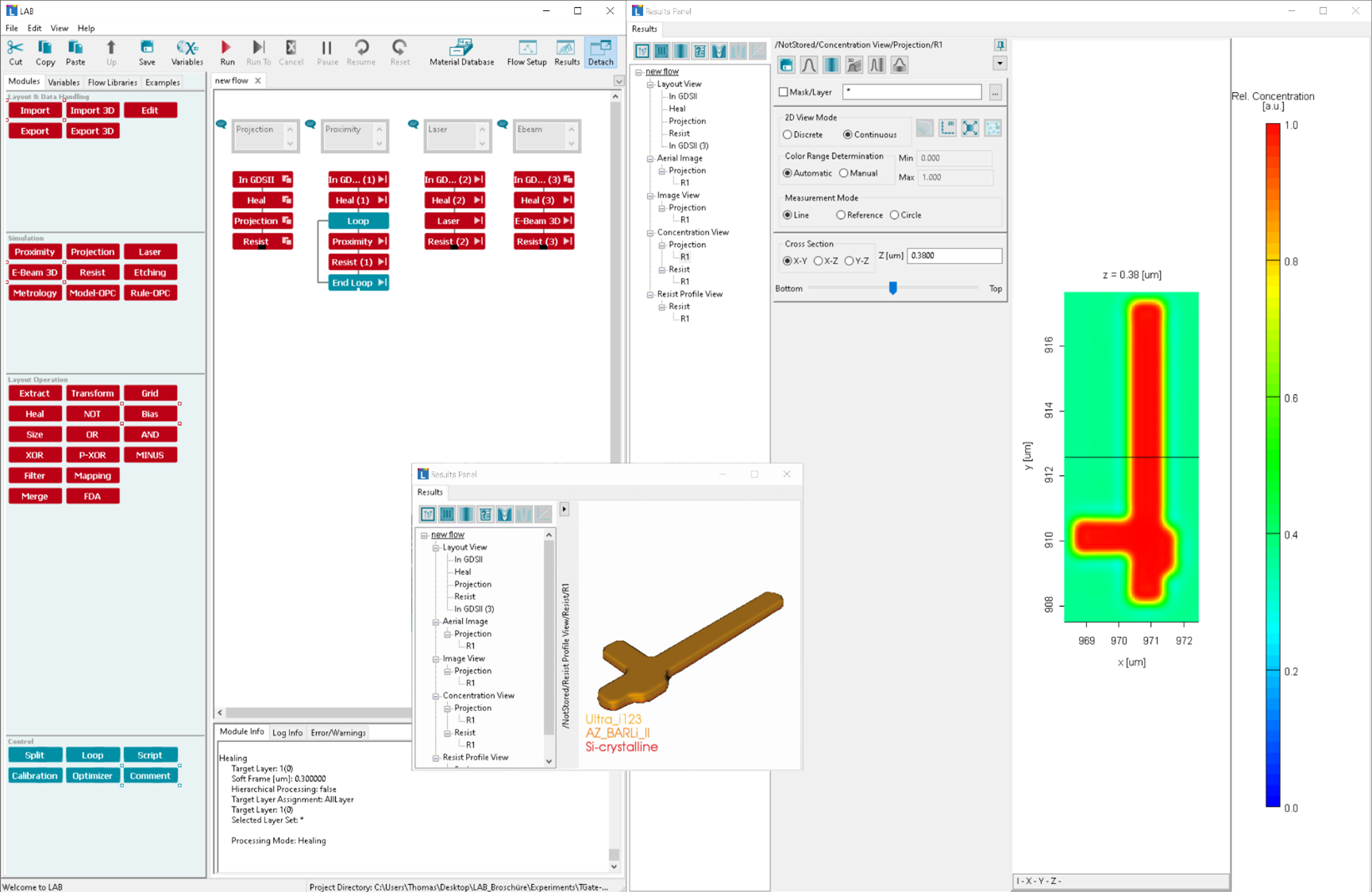
L’ottimizzazione dei processi sperimentali richiede molto tempo e denaro. La simulazione litografica consente di accedere a un gran numero di risultati sperimentali virtuali in un breve lasso di tempo, riducendo notevolmente i costi di sviluppo e il time-to-market grazie alla rapida esplorazione virtuale di un gran numero di parametri.
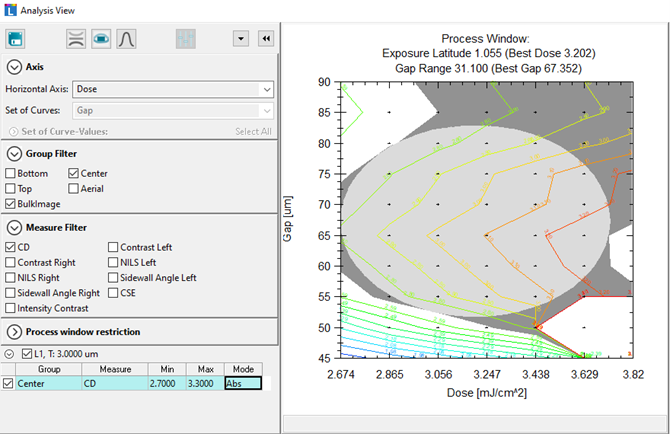
LAB consente di modellare la litografia di prossimità, a proiezione, laser e a fascio di elettroni, per applicazioni quali la produzione di circuiti integrati, i display a schermo piatto, i LED, i MEMS, il packaging 3D, la realizzazione di maschere e la nanofabbricazione. Il calcolo rapido e accurato dell’immagine dell’intensità consente di ottimizzare il layout tramite Rule-OPC e Model-OPC, di verificare il layout della maschera, di ottimizzare gli strati e di analizzare le finestre di processo (ad esempio, deviazione o defocus e variazione della dose di esposizione).
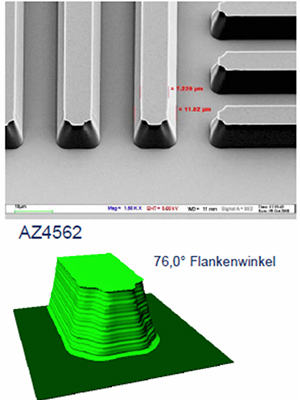
È possibile calcolare migliaia di esperimenti in una notte, senza dover produrre maschere o bruciare i wafer. Una volta ottenuto un buon contrasto d’immagine, la modellazione 3D dello sviluppo del fotoresist permette di ottimizzare ulteriormente i profili del fotoresist.
Litografia di prossimità (allineatore di maschere)
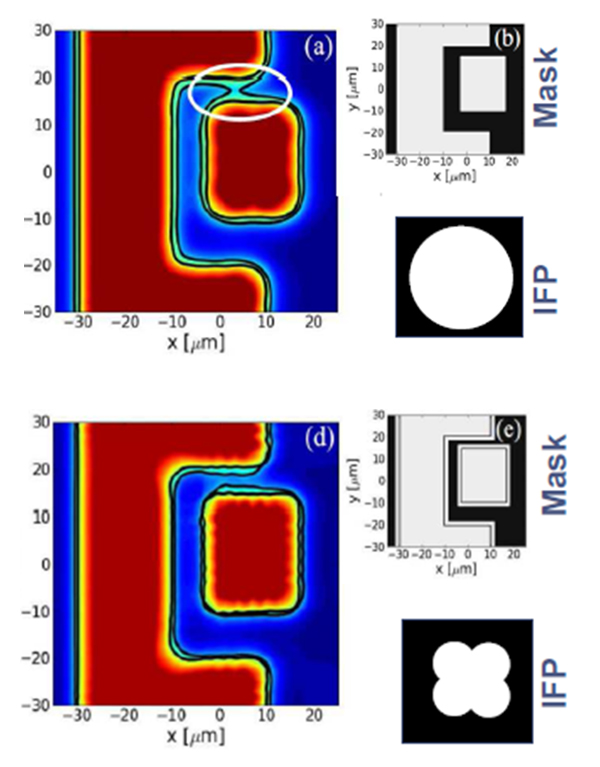
L’intensità a distanze arbitrarie tra maschera e wafer, dal contatto alla prossimità, viene calcolata utilizzando gli integrali di Rayleigh Sommerfeld, che tengono conto di tutti gli ordini di diffrazione diffusi dalla maschera.
- Modella gli effetti della riflessione e della rifrazione nella litografia di prossimità, ad esempio nelle stampanti di prossimità ad ampia superficie, nei dispositivi di esposizione dei filtri colorati FPD e negli allineatori di maschere.
- Qualsiasi tipo di sorgente con spettro e forma arbitrari, ad esempio lampada al mercurio a banda larga, laser, angolo di collimazione e forme personalizzate della sorgente.
- Consente il modellamento della sorgente e l’ottimizzazione della maschera sorgente (SMO) per migliorare la risoluzione
- Supporto per SÜSS MO Exposure Optics®,
- Maschere binarie, in scala di grigi o a spostamento di fase
- Tutti i tipi di substrato, rivestimento, fotoresistenza e topografia
- Simulazione di fotoresist spessi oltre i 100 µm
Tradotto con DeepL.com (versione gratuita)
ProSEM analizza i file di immagine del SEM e fornisce misure di caratteristiche rapide e affidabili per le attività di calibrazione e monitoraggio dei processi.

