LAB
LAB
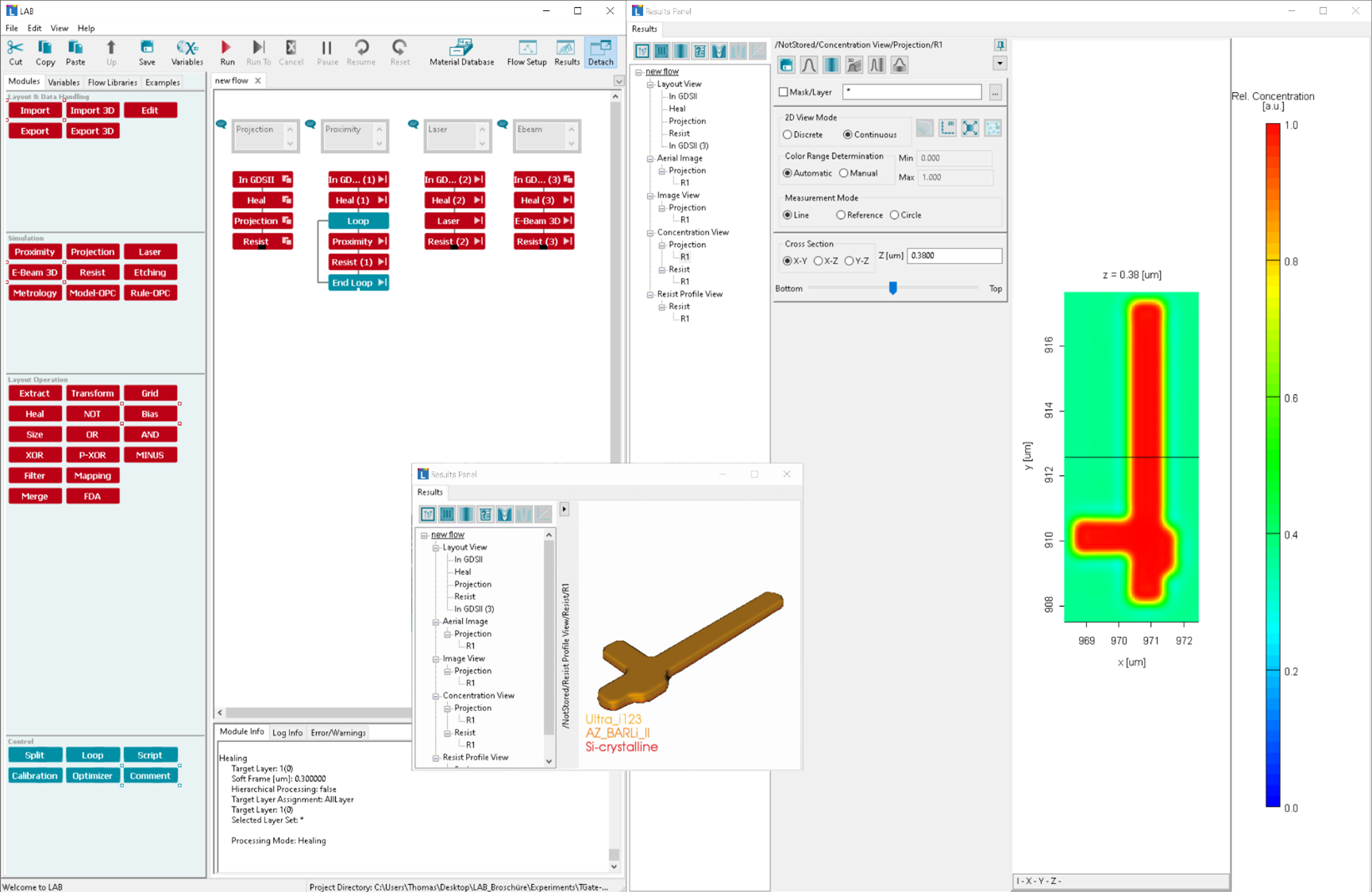
L’optimisation expérimentale des processus est très longue et coûteuse. La simulation de la lithographie permet d’accéder à de nombreux résultats d’expériences virtuelles en peu de temps, réduisant ainsi considérablement les coûts de développement et le temps de commercialisation par l’exploration virtuelle rapide d’une grande quantité de paramètres.
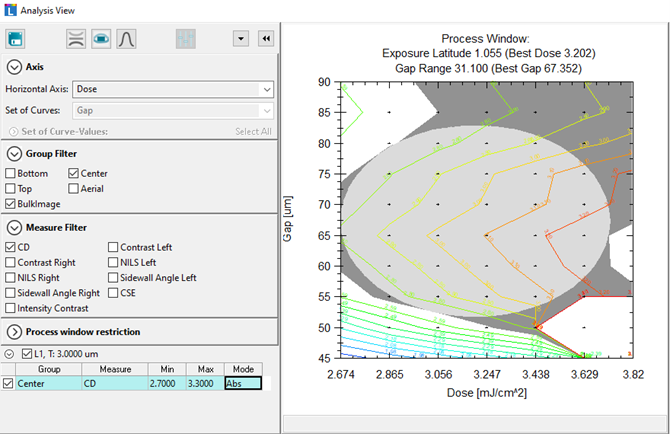
LAB permet la modélisation de la lithographie par proximité, projection, laser et à faisceau d’électrons, pour des applications telles que la fabrication de circuits intégrés, les afficheurs à écran plat, les LED, les MEMS, le packaging 3D, la fabrication de masques et la nanofabrication. Le calcul rapide et précis de l’image d’intensité permet d’optimiser le layout via Rule-OPC et Model-OPC, la vérification du layout du masque, l’optimisation des couches et l’analyse des fenêtres de processus (par exemple, écart ou défocalisation et variation de la dose d’exposition).
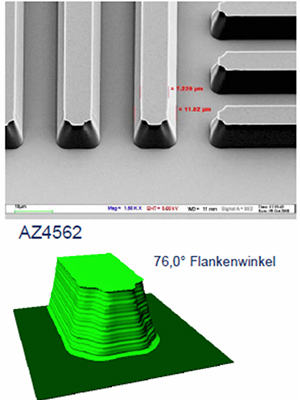
Des milliers d’expériences peuvent être calculées « overnight» sans qu’il soit nécessaire de produire des masques ou de graver des wafers. Une fois qu’un bon contraste d’image a été obtenu, la modélisation 3D du développement du photorésist permet une optimisation supplémentaire des profils du photorésist.
Lithographie de proximité (aligneur de masque)
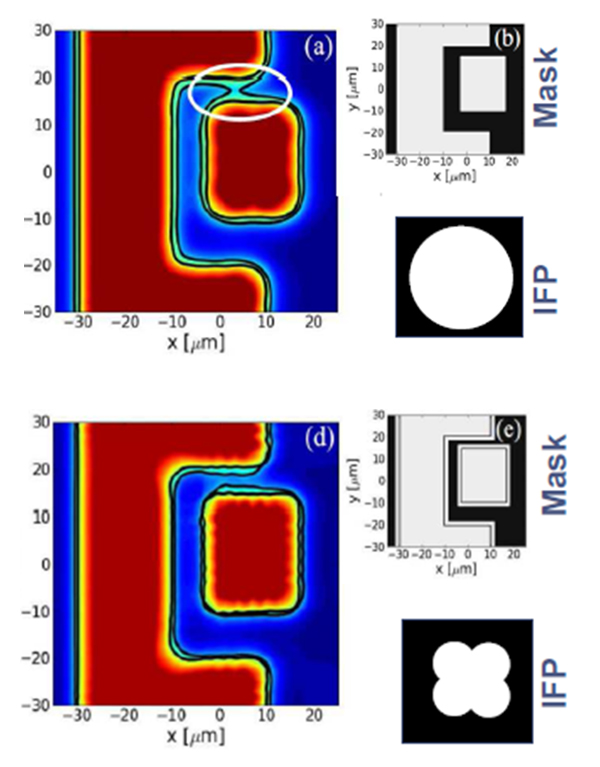
L’intensité à des distances arbitraires entre le masque et le wafer, du contact à la proximité, est calculée en utilisant les intégrales de Rayleigh Sommerfeld, qui prennent en compte tous les ordres de diffraction diffusés par le masque.
- Modélise les effets de la réflexion et de la réfraction dans la lithographie de proximité, p.ex. imprimantes de proximité de grande surface, appareils d’exposition à filtre couleur FPD et aligneurs de masques
- Tout type de source avec spectre et forme arbitraires, p.ex. lampe au mercure à large bande, laser, angle de collimation et formes de source personnalisées
- Permet le façonnage de la source et l’optimisation du masque source (SMO, Source Mask Optimisation) pour améliorer la résolution
- Support pour SÜSS MO Exposure Optics®,
- Masques binaires, à niveaux de gris ou à décalage de phase
- Tout type de substrat, de revêtement, de photorésist et de topographie
- Simulation de photorésist épais dans la gamme au-delà des 100 µm
ProSEM analyse vos fichiers d’images MEB et vous fournit des mesures de caractéristiques rapides et fiables pour vos tâches de calibration et de surveillance du processus.

